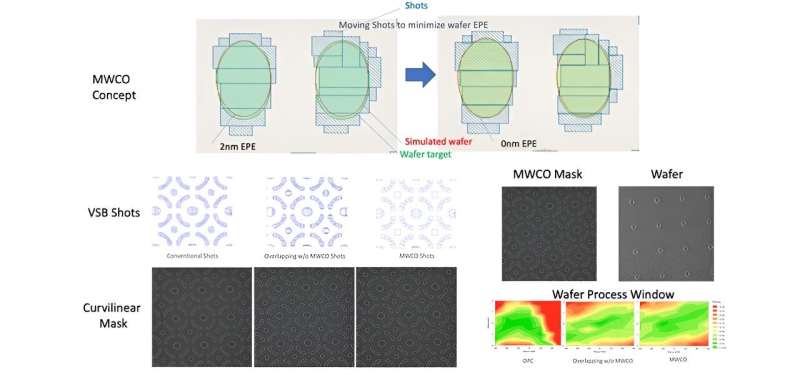
En el corazón del avance de la tecnología de chips semiconductores se encuentra un desafío crítico:crear componentes electrónicos más pequeños y más eficientes. Este desafío es particularmente evidente en el campo de la litografía, el proceso utilizado para crear patrones intrincados en materiales semiconductores (llamados obleas) para la producción de chips.
La litografía utiliza una especie de plantilla, llamada fotomáscara (o simplemente máscara) para crear patrones en obleas semiconductoras. La industria siempre está buscando métodos que mejoren la resolución y la capacidad de fabricación tanto de máscaras como de obleas, lo que producirá chips más rápidos con mayor rendimiento de chips que funcionen correctamente.
Las técnicas de litografía computacional que mejoran la resolución y la fidelidad del patrón, como la corrección óptica de proximidad (OPC), han logrado avances significativos para abordar estos desafíos al modificar los patrones de máscara individuales para mejorar la impresión tanto de máscara como de oblea.
La tecnología de litografía inversa (ILT), un enfoque matemático riguroso que determina las formas de las máscaras que producirán los resultados deseados en la oblea, se ha considerado una solución prometedora para muchos de los desafíos de la litografía para chips avanzados. Desde su introducción hace más de una década, se han realizado numerosos estudios que demuestran que las formas curvilíneas de las máscaras ILT, en particular, producen los mejores resultados de oblea.
Sin embargo, hasta hace poco, los tiempos de ejecución asociados con esta técnica computacional han limitado su aplicación práctica a "puntos críticos" de los chips. En 2019, se propuso un sistema completamente nuevo y especialmente diseñado, que incluye un enfoque único acelerado por GPU que emula un único par de GPU/CPU gigante que puede calcular una solución ILT completa de chip completo a la vez. Este novedoso enfoque, diseñado sistemáticamente para ILT y aceleración de GPU, hizo que ILT de chip completo fuera una realidad práctica en producción.
Sin embargo, este enfoque se basó en la escritura de máscaras multihaz, un nuevo desarrollo importante en la escritura de máscaras que se basa en píxeles y, por lo tanto, es independiente de la forma en términos de tiempo de escritura. La pregunta que quedaba era si los beneficios de la ILT curvilínea de chip completo podrían extenderse a los escritores de máscaras de haz de forma variable (VSB) que escriben formas rectilíneas (y a veces triangulares) en lugar de píxeles, y que constituyen la mayoría de los escritores de máscaras. en todo el mundo hoy.
Mientras que los escritores VSB crean rápidamente formas rectangulares más grandes escribiendo una toma rectangular a la vez, los patrones de máscara complejos pueden ser un problema porque la gran cantidad de rectángulos pequeños necesarios para crearlos tomaría demasiado tiempo para escribir.
Reportando su trabajo en el Journal of Micro/Nanopatterning, Materials, and Metrology , el equipo de D2S, Inc. inventó un método llamado cooptimización de oblea de máscara (MWCO) con tres ideas:el escritor de máscara y el escáner de oblea son filtros de paso bajo; los disparos superpuestos guiados por simulación de máscara/oblea pueden crear formas curvilíneas con menos disparos; Al enfocarse en el patrón de oblea, en lugar del patrón de máscara, se pueden crear tomas mucho más simples para imprimir el patrón de oblea correcto. Al utilizar esta doble simulación, la calidad de impresión de las obleas se optimiza de forma iterativa mientras se manipulan los bordes de los disparos VSB para producir formas de máscara de destino rectilíneas que se sabe que se pueden escribir en un escritor VSB, con un recuento de disparos conocido y aceptable.
D2S y Micron Technology han demostrado que MWCO puede reducir la variación de la oblea hasta 3 veces y puede mejorar la ventana del proceso de oblea hasta 2 veces en comparación con Micron OPC, lo que indica una mejora sustancial en la precisión y confiabilidad del proceso de litografía. El tiempo de escritura para una máscara ILT completamente curvilínea sería de menos de 12 horas, satisfaciendo los requisitos de producción de gran volumen.
Esto significa que todos los fabricantes de semiconductores ahora pueden producir chips que no sólo son más pequeños sino que también tienen mayor rendimiento y menor consumo de energía, incluso si no tienen acceso a un escritor de máscara multihaz.
Más información: Linyong (Leo) Pang et al, Haga posible lo imposible:utilice escritores de máscaras de haz de forma variable y tecnología de litografía inversa curvilínea de chip completo para contactos/vías 193i con cooptimización de máscara-oblea, Journal of Micro/Nanopatterning, Materiales y Metrología (2024). DOI:10.1117/1.JMM.23.1.011207
Proporcionado por SPIE