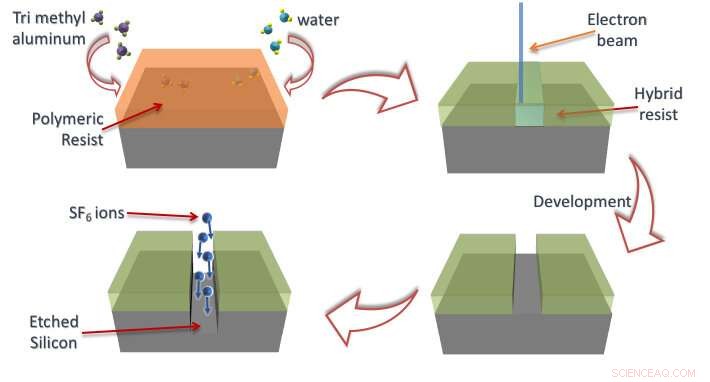
Un esquema que muestra el proceso de creación de la resistencia híbrida orgánico-inorgánica a través de la síntesis de infiltración, modelado de la resistencia a través de la litografía por haz de electrones, y grabar el patrón en silicio bombardeando la superficie del silicio con iones de hexafluoruro de azufre (SF6). Crédito:Laboratorio Nacional Brookhaven
Para aumentar la velocidad de procesamiento y reducir el consumo de energía de los dispositivos electrónicos, la industria de la microelectrónica continúa presionando por tamaños de características cada vez más pequeños. Los transistores de los teléfonos móviles actuales suelen tener un diámetro de 10 nanómetros (nm), equivalente a unos 50 átomos de silicio de ancho, o menos. Escalar transistores por debajo de estas dimensiones con mayor precisión requiere materiales avanzados para litografía, la técnica principal para imprimir elementos de circuitos eléctricos en obleas de silicio para fabricar chips electrónicos. Uno de los desafíos es desarrollar "resistencias" robustas, "o materiales que se utilizan como plantillas para transferir patrones de circuitos a sustratos útiles para dispositivos, como el silicio.
Ahora, Científicos del Centro de Nanomateriales Funcionales (CFN), una instalación para usuarios de la Oficina de Ciencias de la Oficina del Departamento de Energía de EE. UU. en el Laboratorio Nacional de Brookhaven, han utilizado la técnica recientemente desarrollada de síntesis por infiltración para crear resistencias que combinan el polímero orgánico poli (metacrilato de metilo ), o PMMA, con óxido de aluminio inorgánico. Debido a su bajo costo y alta resolución, El PMMA es el material protector más utilizado en la litografía por haz de electrones (EBL), una especie de litografía en la que se utilizan electrones para crear la plantilla del patrón. Sin embargo, en los espesores de resistencia que son necesarios para generar los tamaños de características ultrapequeños, los patrones generalmente comienzan a degradarse cuando se graban en silicio, no producir la alta relación de aspecto requerida (alto a ancho).
Como se informó en un artículo publicado en línea el 8 de julio en el Revista de Química de Materiales C , estas resistencias orgánicas-inorgánicas "híbridas" exhiben un alto contraste litográfico y permiten el modelado de nanoestructuras de silicio de alta resolución con una alta relación de aspecto. Al cambiar la cantidad de óxido de aluminio (o un elemento inorgánico diferente) infiltrado en PMMA, los científicos pueden ajustar estos parámetros para aplicaciones particulares. Por ejemplo, Los dispositivos de memoria de próxima generación, como las unidades flash, se basarán en una estructura de apilamiento tridimensional para aumentar la densidad de la memoria. por lo que es deseable una relación de aspecto extremadamente alta; por otra parte, una resolución muy alta es la característica más importante para futuros chips de procesador.
"En lugar de tomar una ruta de síntesis completamente nueva, usamos una resistencia existente, un óxido de metal económico, y equipos comunes que se encuentran en casi todas las instalaciones de nanofabricación, "dijo el primer autor Nikhil Tiwale, investigador asociado postdoctoral en el CFN Electronic Nanomaterials Group.
Aunque se han propuesto otras resistencias híbridas, la mayoría de ellos requieren altas dosis de electrones (intensidades), implican métodos complejos de síntesis química, o tienen costosas composiciones patentadas. Por lo tanto, estas resistencias no son óptimas para los de alta velocidad, fabricación de gran volumen de productos electrónicos de última generación.
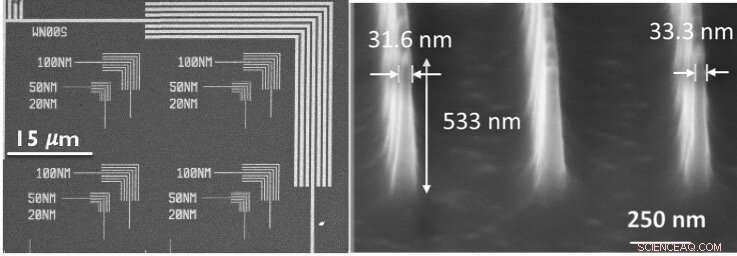
Izquierda:una imagen de microscopio electrónico de barrido (SEM) de nanopatrones de silicio en forma de codo con diferentes tamaños de características (anchos de línea). Derecha:una imagen SEM de gran aumento de alta resolución, nanoestructuras de silicio de alta relación de aspecto modeladas con una resolución de paso (ancho de línea más ancho de espacio, o espacio entre líneas) de 500 nm. Crédito:Laboratorio Nacional Brookhaven
Nanolitografía avanzada para la fabricación de grandes volúmenes
Convencionalmente la industria de la microelectrónica se ha basado en la litografía óptica, cuya resolución está limitada por la longitud de onda de la luz a la que se expone la resistencia. Sin embargo, EBL y otras técnicas de nanolitografía como la litografía ultravioleta extrema (EUVL) pueden empujar este límite debido a la longitud de onda muy pequeña de los electrones y la luz ultravioleta de alta energía. La principal diferencia entre las dos técnicas es el proceso de exposición.
"En EBL, debe escribir toda el área que necesita exponer línea por línea, algo así como hacer un boceto con un lápiz, "dijo Tiwale." Por el contrario, en EUVL, puedes exponer toda el área de una sola vez, similar a tomar una fotografía. Desde este punto de vista, EBL es ideal para fines de investigación, y EUVL es más adecuado para la fabricación de grandes volúmenes. Creemos que el enfoque que demostramos para EBL se puede aplicar directamente a EUVL, que empresas como Samsung han comenzado a utilizar recientemente para desarrollar procesos de fabricación para su nodo de tecnología de 7 nm ".
En este estudio, Los científicos utilizaron un sistema de deposición de capa atómica (ALD), una pieza estándar de equipo de nanofabricación para depositar películas ultrafinas en superficies, para combinar PMMA y óxido de aluminio. Después de colocar un sustrato recubierto con una película delgada de PMMA en la cámara de reacción ALD, introdujeron un vapor de un precursor de aluminio que se difundió a través de diminutos poros moleculares dentro de la matriz de PMMA para unirse con las especies químicas dentro de las cadenas de polímero. Luego, introdujeron otro precursor (como el agua) que reaccionó con el primer precursor para formar óxido de aluminio dentro de la matriz de PMMA. Estos pasos juntos constituyen un ciclo de procesamiento.
Luego, el equipo realizó EBL con resistencias híbridas que tenían hasta ocho ciclos de procesamiento. Para caracterizar el contraste de las resistencias bajo diferentes dosis de electrones, los científicos midieron el cambio en el espesor de la capa protectora dentro de las áreas expuestas. Mapas de altura de la superficie generados con un microscopio de fuerza atómica (un microscopio con una punta atómicamente afilada para rastrear la topografía de una superficie) y mediciones ópticas obtenidas mediante elipsometría (una técnica para determinar el espesor de la película basada en el cambio en la polarización de la luz reflejada desde un superficie) reveló que el espesor cambia gradualmente con un número bajo de ciclos de procesamiento, pero rápidamente con ciclos adicionales, es decir, un mayor contenido de óxido de aluminio.

Después de dos ciclos de procesamiento, la selectividad de grabado de la resistencia híbrida supera a la de ZEP, una costosa resistencia. Después de cuatro ciclos, la capa protectora híbrida tiene una selectividad de grabado un 40 por ciento más alta que la del dióxido de silicio (SiO 2 ). Crédito:Laboratorio Nacional Brookhaven
"El contraste se refiere a qué tan rápido cambia la resistencia después de ser expuesta al haz de electrones, "explicó Chang-Yong Nam, un científico de materiales en el CFN Electronic Nanomaterials Group, quien supervisó el proyecto y concibió la idea en colaboración con Jiyoung Kim, profesor del Departamento de Ciencia e Ingeniería de Materiales de la Universidad de Texas en Dallas. "El cambio abrupto en la altura de las regiones expuestas sugiere un aumento en el contraste de la capa protectora para un mayor número de ciclos de infiltración, casi seis veces mayor que la de la capa protectora de PMMA original".
Los científicos también utilizaron las resistencias híbridas para modelar líneas rectas periódicas y "codos" (líneas que se cruzan) en sustratos de silicio. y comparó la tasa de grabado de las resistencias con los sustratos.
"Quieres que el silicio se grabe más rápido que la resistencia; de lo contrario, la resistencia comienza a degradarse, ", dijo Nam." Descubrimos que la selectividad de grabado de nuestra resistencia híbrida es mayor que la de las costosas resistencias patentadas (por ejemplo, ZEP) y técnicas que utilizan una capa de máscara "dura" intermedia como el dióxido de silicio para evitar la degradación del patrón, pero que requieren pasos de procesamiento adicionales ".
Avanzando, el equipo estudiará cómo responde el híbrido a la exposición a EUV. Ya han comenzado a usar rayos X suaves (rango de energía correspondiente a la longitud de onda de la luz EUV) en la Fuente de Luz Nacional Sincrotrón II de Brookhaven (NSLS-II), y esperamos utilizar una línea de luz EUV dedicada operada por el Centro de Óptica de Rayos X en la Fuente de Luz Avanzada (ALS) del Laboratorio Nacional Lawrence Berkeley en colaboración con socios de la industria.
"La absorción de energía por la capa orgánica de EUVL resiste es muy débil, ", dijo Nam." Añadiendo elementos inorgánicos, como estaño o circonio, puede hacerlos más sensibles a la luz EUV. Esperamos explorar cómo nuestro enfoque puede abordar los requisitos de rendimiento de resistencia de EUVL ".