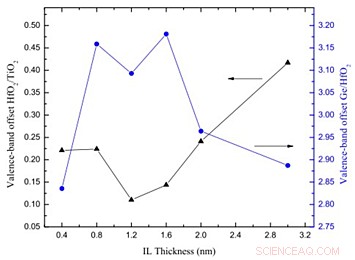
La introducción de una capa intermedia de óxido de hafnio reduce la fuga de electrones entre las capas de óxido de germanio y titanio, que puede mejorar la eficiencia energética y la confiabilidad.
(Phys.org) —La base de muchos, muchos dispositivos electrónicos modernos, incluidas las computadoras, teléfonos inteligentes, y televisores - es el transistor de silicio. Sin embargo, la contracción de la electrónica de consumo está llevando a los investigadores a investigar materiales que pueden producir transistores más delgados. En NSLS, Los investigadores han utilizado rayos X para probar el comportamiento electrónico de una estructura de transistor basada en germanio, proporcionando información importante que guiará los estudios futuros sobre cómo hacer transistores más pequeños.
Un transistor es esencialmente un interruptor que regula el flujo de corriente. Cuando se aplica un cierto voltaje de umbral a través de él, flujos de corriente; debajo de eso, la corriente no fluye. Un transistor muy común consiste en una capa muy delgada (escala nanométrica) de un óxido (típicamente óxido de silicio, SiO2) entre un sustrato de silicio y un electrodo metálico.
Se prefiere el germanio (Ge) para reemplazar al silicio en parte porque los portadores de carga se mueven mucho más rápido dentro de él que en el silicio (Si). Pero el problema más importante es la capa de óxido:cuando el SiO2 se acerca a un grosor de un nanómetro, los electrones comienzan a "filtrarse" a través de él (como resultado del extraño fenómeno físico de los túneles de la mecánica cuántica), conduciendo a un consumo excesivo de energía y poca confiabilidad. Los transistores que utilizan SiO2 no pueden satisfacer la demanda de los consumidores de dispositivos más rápidos.
Recientemente, empresas como Intel han estado fabricando sus transistores utilizando óxido de hafnio (HfO2), que puede ser más delgado y aún así funcionar bien. Tiene una "constante dieléctrica" más alta (abreviada K), que es el valor que determina la robustez de cualquier óxido frente a fugas:cuanto mayor es el valor de K, cuanto menor sea la fuga. Sin embargo, incluso el HfO2 tiene fugas cuando es demasiado delgado.
Los investigadores están investigando óxidos con valores de K más altos, cuales, cuando se combina con germanio, podría producir un transistor más adecuado para la electrónica del mañana. Pero el candidato más prometedor, óxido de titanio (TiO2), también se filtró demasiada corriente cuando se colocó en estructuras de prueba, o "heterouniones, "independientemente de si las estructuras contenían Si o Ge.
Esa fuga fue el resultado de un "desplazamiento de banda" demasiado pequeño. Esto significa que las bandas de conducción de TiO2 no se separaron adecuadamente de las bandas de Si y Ge, permitiendo que los electrones se escapen del Si o Ge al TiO2. Un desplazamiento de banda grande es esencial cuando las capas son tan delgadas, ayudando a evitar que los electrones se muevan entre ellos. Un grupo de investigación (dirigido por Christophe Detavernier en la Universidad de Gante en Bélgica) ha encontrado una buena solución:agregar una fina "capa intermedia" intermedia a sus heterouniones antes de depositar la capa de TiO2. La capa intermedia tiene un desplazamiento de banda más razonable. El estudio de NSLS ha utilizado este desarrollo como punto de partida.
"De esta manera, obtiene lo mejor de ambos:el buen desplazamiento de banda de la capa intermedia y la alta constante dieléctrica del óxido de titanio, "dijo el científico de NSLS Abdul Rumaiz, el autor principal del estudio. "Sin embargo, con el escalado de dispositivos a tamaños más pequeños, el espesor de la capa intermedia debe ser inferior a un nanómetro. Por lo tanto, es muy importante comprender los desplazamientos de banda en dimensiones tan reducidas ".
Rumaiz y colegas del Instituto Nacional de Estándares y Tecnología (NIST), Universidad de Gante, Universidad Quaid-i-Azam (Pakistán), y la Universidad de Delaware estudiaron cómo el grosor de la capa intermedia afectaba las compensaciones de las bandas. Usando rayos X en la línea de luz X24A, que es administrado por NIST, investigaron estructuras de transistores a base de germanio que contienen TiO2 y una capa intermedia de óxido de hafnio (HfO2). Este trabajo y los estudios futuros serán importantes para determinar qué tan delgadas pueden ser las capas y, al mismo tiempo, producir un transistor de alto rendimiento.
El equipo creó seis muestras con diferentes espesores de capa intermedia, de 0,4 nanómetros (nm) a 3 nm, y un espesor fijo de TiO2 de 2 nm. Estudiaron la estructura con espectroscopia de fotoelectrones de rayos X duros, o HAXPES, una técnica que mide los electrones que emite un material cuando se expone a un haz de rayos X de alta energía (duros). Estas mediciones pueden informar a los científicos sobre las propiedades electrónicas de un material y también revelar información sobre las interfaces entre los materiales.
Comenzaron con una oblea de germanio, que formó una capa muy fina de "óxido nativo" después de la exposición al oxígeno. Sobre el óxido nativo, el equipo agregó el HfO2 y luego el óxido de titanio (TiO2) utilizando una técnica llamada deposición de capa atómica.
El análisis HAXPES mostró que a medida que aumentaba el grosor de la capa intermedia, las compensaciones de banda también aumentaron. Reveló varios otros detalles electrónicos y estructurales, también. Por ejemplo, el óxido nativo de germanio cambió a un estado de oxidación más alto, lo que significa que perdió electrones y también aumentó de espesor. No hubo evidencia de que la capa de TiO2 mezclada con la capa de HfO2, pero hubo evidencia de que la capa de HfO2 se mezcló con la capa de óxido de germanio debajo de ella, formando enlaces Hf-Ge. Los resultados indican que los investigadores deben tener cuidado al hacer suposiciones sobre el desplazamiento de banda.
Esta investigación se publica en el 27 de noviembre de 2012, edición en línea de Letras de física aplicada .