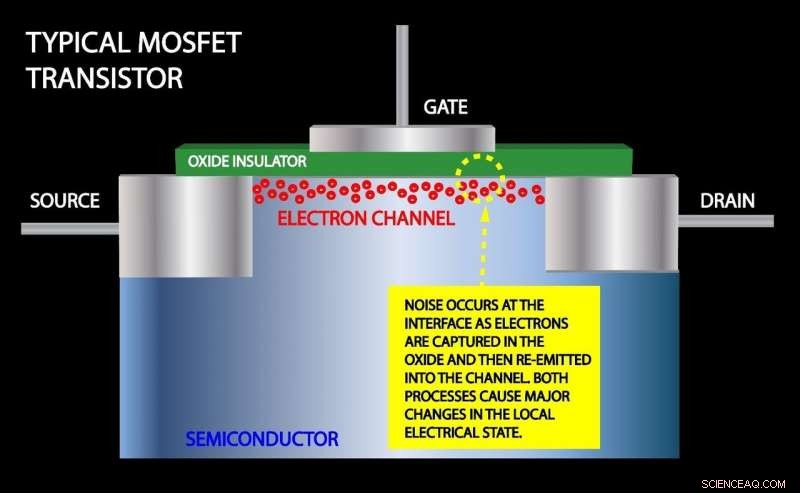
Crédito:Instituto Nacional de Estándares y Tecnología
Un modelo completamente nuevo de la forma en que los electrones son atrapados y liberados brevemente en pequeños dispositivos electrónicos sugiere que una larga aceptación, La visión de toda la industria es simplemente errónea sobre la forma en que estos electrones capturados afectan el comportamiento de los componentes de hardware, como las celdas de memoria flash.
El modelo, ideado por científicos del Instituto Nacional de Estándares y Tecnología (NIST), fue probado para explicar cómo la captura y emisión de electrones crea el ruido insidioso que amenaza cada vez más el rendimiento a medida que los dispositivos electrónicos continúan reduciéndose de tamaño.
Esos efectos, conocido como ruido de ráfaga, el ruido de las palomitas de maíz o el ruido telegráfico aleatorio (RTN) "se han convertido en un problema importante para dispositivos extremadamente pequeños, "dijo el investigador del NIST Kin Cheung, el autor principal de un nuevo informe en IEEE Transactions on Electron Devices.
La captura de carga es una de las causas conocidas de fallas en la memoria flash. El nuevo modelo, que el físico del NIST John Kramar llamó "un gran cambio de paradigma en el modelado de captura de carga, "podría llevar a un enfoque diferente para manejar este problema, y potencialmente, una nueva forma de hacer las células de memoria más pequeñas.
El ruido RTN consiste en caídas aleatorias abruptas de voltaje o corriente causadas por electrones itinerantes que se capturan brevemente de, y luego reincorporarse, el flujo principal a lo largo de un canal de corriente en, por ejemplo, un tipo común de transistor llamado MOSFET.
“El efecto era mayormente insignificante en los viejos tiempos, cuando los dispositivos eran más grandes y había muchos electrones fluyendo alrededor, ", Dijo Cheung. Pero en los dispositivos avanzados de hoy, con dimensiones de características en el rango de 10 nanómetros (nm, mil millonésimas de metro) o menos, el área activa es tan pequeña que puede ser inundada por una sola carga atrapada.
"Al llegar a los tamaños más pequeños, RTN puede ser casi un 100 por ciento más fuerte que la señal que está tratando de medir, "Dijo Cheung." En esas condiciones, la fiabilidad desaparece ".
En el caso de RTN, Se conocen los conceptos básicos:el ruido es causado por la acción de electrones cerca de la interfaz entre dos materiales, como una capa aislante y la mayor parte del semiconductor en un transistor. Específicamente, un electrón se extrae del flujo de corriente y queda atrapado en un defecto en el aislante; despues de un corto tiempo, se emite de nuevo a la corriente principal del semiconductor. Qué sucede realmente a escala atómica en cada etapa del proceso, sin embargo, se comprende de forma incompleta.

Crédito:Instituto Nacional de Estándares y Tecnología
El enfoque ortodoxo para explicar esos efectos es tratar todos los electrones atrapados como una sola hoja de carga bidimensional que se extiende uniformemente a través del centro del aislante. Se cree que cada electrón emitido regresa al semiconductor en un proceso inverso al mismo por el cual fue capturado. provocando muy pocos cambios en el estado presumiblemente estable a lo largo del límite aislante / semiconductor.
Ese modelo, cuando se aplica a dispositivos muy pequeños, no tenía sentido para los científicos del NIST. Entre otras dificultades, ignoró el hecho de que, una vez inmovilizados, los electrones causan distorsiones considerables en las condiciones del campo eléctrico local a lo largo del límite, afectando el flujo de corriente. "Estamos diciendo que la forma tradicional realmente no funciona, "Dijo Cheung." Tienes que repensar esto. El modelo anterior no hace suposiciones razonables sobre cómo se comportan los portadores de cargos ".
Los investigadores propusieron un nuevo modelo, basado en efectos locales, en el que los mecanismos de captura y emisión son dramáticamente diferentes de la imagen estándar. Por una cosa, determinaron que la mecánica cuántica, la teoría moderna que describe el comportamiento de estos sistemas, lo hace enormemente improbable, si no imposible, para que los electrones salgan del aislante de la misma manera que entraron.
"Es como una autopista donde hay una rampa de salida, pero no hay rampa ", dice el coautor del NIST Jason Campbell." Puede entrar, pero no puedes volver de esa manera. Tienes que volver de otra manera. Es decir, hay un conjunto de reglas para la captura que no se aplican a la emisión ".
"Cuando te das cuenta de que los procesos de captura y emisión están desacoplados, "Cheung dijo, "rápidamente tienes una visión muy diferente del problema".
La imagen RTN estándar supone una interacción débil de la carga atrapada con su entorno local, en este caso, la carga eléctrica altamente separada en el dióxido de silicio que a menudo forma la capa aislante en un transistor. Los científicos del NIST encontraron que una interacción débil es inconsistente con la física conocida y no está de acuerdo con los informes de dos laboratorios independientes. En efecto, la energía de interacción de un electrón capturado puede ser más de 10 veces mayor de lo que se creía anteriormente. El reconocimiento de esta energía de interacción más fuerte permite que la nueva imagen de campo local explique la RTN de forma natural.
El éxito del nuevo modelo, y el cambio drástico resultante en la comprensión de la captura y la emisión, sugirió que muchas ideas de larga data deberían reconsiderarse a fondo.
"Eso fue muy aterrador, conclusión muy inquietante, "Campbell dijo." Quiero decir, esto es algo para romper el libro de texto ".
Los investigadores esperan que el nuevo modelo ayude a los ingenieros y diseñadores de chips a comprender con mucho mayor detalle cómo se degradan los dispositivos. y lo que se necesitará para pasar a la siguiente etapa de miniaturización mientras se mantiene la confiabilidad y se reduce el ruido.
Esta historia se vuelve a publicar por cortesía de NIST. Lea la historia original aquí.