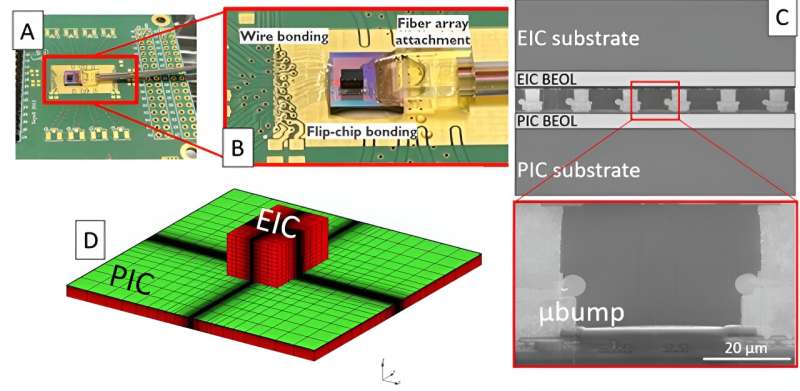
Los avances recientes en inteligencia artificial y, más específicamente, en grandes modelos de lenguaje como ChatGPT, han ejercido presión sobre los centros de datos. Los modelos de IA requieren enormes cantidades de datos para entrenarse y, para mover datos entre las unidades de procesamiento y la memoria, se necesitan enlaces de comunicación eficientes.
Para las comunicaciones de larga distancia, la fibra óptica ya ha sido la solución preferida durante décadas. Para las comunicaciones de corta distancia dentro del centro de datos, la industria también está empezando a adoptar la fibra óptica debido a su gran rendimiento en comparación con los enlaces eléctricos clásicos. Los recientes avances tecnológicos ahora permiten incluso el cambio de interconexión eléctrica a óptica para distancias muy pequeñas, como la comunicación entre chips dentro del mismo paquete.
Esto requiere una conversión del flujo de datos del dominio eléctrico al óptico, lo que ocurre en el transceptor óptico. La fotónica de silicio es la tecnología más utilizada para fabricar estos transceptores ópticos.
Los dispositivos fotónicos activos dentro del chip (moduladores y fotodetectores) aún requieren una conexión con controladores electrónicos para alimentar los dispositivos y leer los datos entrantes. Al apilar el chip electrónico (EIC) justo encima del chip fotónico (PIC) mediante tecnología de apilamiento 3D se logra una integración muy estrecha de los componentes con baja capacitancia parásita.
En una investigación publicada recientemente en el Journal of Optical Microsystems , se investiga el impacto térmico de esta integración 3D.
El diseño del chip fotónico consta de una serie de moduladores en anillo, conocidos por su sensibilidad a la temperatura. Para operar en un entorno exigente, como un centro de datos, necesitan una estabilización térmica activa. Esto se implementa en forma de calentadores integrados. Por razones de eficiencia energética, es evidente que se debe minimizar la potencia necesaria para la estabilización térmica.
El equipo de investigación de KU Leuven e Imec en Bélgica midió experimentalmente la eficiencia del calentador de los moduladores en anillo antes y después de la unión del chip invertido del EIC al PIC. Se encontró una pérdida relativa de -43,3% en eficiencia, lo que es un impacto significativo.
Además, las simulaciones de elementos finitos en 3D atribuyeron esta pérdida a la propagación del calor en el EIC. Esta dispersión de calor debe evitarse porque, en el caso ideal, todo el calor generado en el calentador integrado se encuentra cerca del dispositivo fotónico. La diafonía térmica entre los dispositivos fotónicos también aumentó hasta un +44,4 % después de unir el EIC, lo que complica el control térmico individual.
Cuantificar el impacto térmico de la integración fotónica-electrónica 3D es esencial, pero también lo es prevenir la pérdida de eficiencia del calentador. Por esta razón, se realizó un estudio de simulación térmica donde se cambiaron variables típicas de diseño con el objetivo de aumentar la eficiencia del calentador. Se muestra que al aumentar el espacio entre los µbumps y el dispositivo fotónico y al disminuir el ancho de la línea de interconexión, se puede minimizar la penalización térmica de la integración 3D.
Más información: David Coenen et al, Modelado térmico de transceptores fotónicos-electrónicos de silicio basados en anillos integrados tridimensionales híbridos, Journal of Optical Microsystems (2023). DOI:10.1117/1.JOM.4.1.011004
Proporcionado por SPIE